1IBMНЋЙЋВМ3DаОЦЌЯИНкЛиЖЅВП ЁЁЁЁЁОPConline зЪбЖЁПИљОнзюаТЯћЯЂЃЌIBMЭИТЖСЫЦф3DаОЦЌЕФвЛаЉММЪѕЯИНкЃЌ45nmжЦГЬЙЄвеЕФДІРэЦїКЭФкДцзщГЩСЂЬхНсЙЙЃЌзїЮЊЗўЮёЦїЕФКЫаФЃЌCPUЕФММЪѕвЛБИЪмжѕФПЃЌзюНќгЩгкОЇЬхЙмГпДчНгНќЮяРэМЋЯоЃЌФІЖћЖЈТЩЪмЕНЬєеНЃЌбАеваТММЪѕеќОШФІЖћЖЈТЩвВГЩЮЊЕБЧАаОЦЌжЦдьепЕФНЙЕуЁЃ 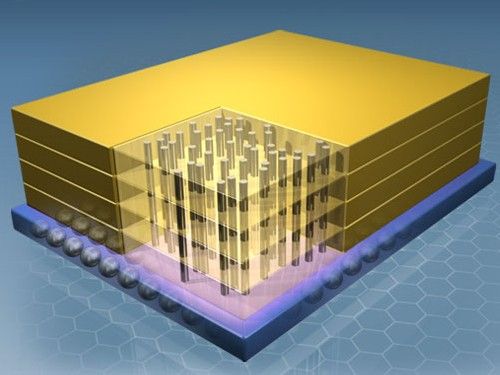
3D аОЦЌ
ЁЁЁЁИљОнЙњЭтУНЬхБЈЕРГЦЃЌIBMНЋЛсдкОЩН№ЩНОйааЕФIDEM2012ДѓЛсЩЯЙЋВМ3DаОЦЌЕФвЛаЉММЪѕЯИНкЃЌЙњМЪЕчзгЩшБИДѓЛсгазХ60грФъЕФРњЪЗЃЌЛуОлзХДІРэЦїаОЦЌЁЂФкДцЕШЕФЩшМЦЁЂММЪѕЕШзюаТШШЕуЁЃ 
IDEM2012
ЁЁЁЁIBMдЄбдЮДРДаОЦЌОЇЬхЙмНЋЛсгаКмДѓЕФИФБфЃЌФПЧАЪЧЗЂеЙЕНМЏГЩЕчТЗЕФЪБЦкЃЌКмПьОЭЛсНјШыЃЈStacks DieЃЉКЫаФЖбеЛЕФЪБЦкЃЌЖјдкЮДРДНЋЛсЪЧФЃПщЛЏЕФЩшМЦЁЃ 
ОЇЬхЙмБфЛЏ
ЁЁЁЁSubraman S. IyerЃЌIBMИпМЖММЪѕЙЄГЬЪІБэЪОЃЌ3DФЃПщЛЏЕФРЉеЙадМмЙЙЃЌФмЙЛШУФІЖћЖЈТЩжиЛёаТЩњЁЃ>> ШчЙћФњгаЪВУДЗўЮёЦїЮЪЬтЃЌЧыЕуЛївдЯТСДНгЃЌНјШыPConlineВњЦЗТлЬГЬжТлЃК
//itbbs.pconline.com.cn/network/f768799.html ЁЁЁЁIBMЕФЮФМўЯдЪОЃЌЦф3DДІРэЦїМмЙЙЙВгаСНВуаОЦЌЃЌЦфжаЕзВуЕФДІРэЦїОЙ§ЬиЪтДІРэЯрБШРДЫЕЛсБЁвЛЕуЃЌСНВуаОЦЌжЎМфЭЈЙ§Pb-Free C4ЯрСЌНгЁЃ 
3DДІРэЦїМмЙЙ
ЁЁЁЁIBMЖд3DаОЦЌЕФбаОПгЩРДвбОУЃЌЦфКЭУРЙтЙЋЫОЃЈMicronЃЉМЦЛЎЭЦГіЕФ3DФкДцаОЦЌHMCЃЌДцШЁЪ§ОнФмДя128GbpsЃЌЪЧФПЧАФкДцЕФ10БЖЁЃЫцзХаОЦЌжЦГЬЙЄвеДг65nmЃЌ45nmдйЕН22nmЃЌЕчТЗЕФУмМЏЖШдНРДдНИпЃЌЪЦБиЛсДяЕНвЛИіММЪѕЩЯЕФЦПОБЃЌдкЕчТЗУмМЏЖШЩЯДяЕНвЛИіМЋЯоЃЌЖј3DаОЦЌЕФЩшМЦИХФюЕФГіЯжЃЌИјЬсИпаОЦЌадФмПЊЭиСЫСэЭтвЛИіЭООЖЁЃ  ЁЁ ЁЁ
Hybrid Memory Cube
ЁЁЁЁHybrid Memory CubeЃЈHMCЃЉЃЌЛьКЯСЂЗНФкДцаОЦЌЃЌгЩУРЙтЙЋЫОЬсГіЃЌетжжЛьКЯСЂЬхФкДцгыCPUЕФЪ§ОнДЋЪфЫйЖШНЋЪЧЯжНзЖЮФкДцММЪѕЕФ15БЖЃЌвдБуЪЪгІИпЫйЗЂеЙЕФДІРэЦїКЭПэДјЭјТчЁЃ ЁЁЁЁГ§СЫ3DаОЦЌФкДцЃЌРЖЩЋОоШЫIBMЛЙЛ§МЋгыИїГЇЩЬКЯзїЭЦНј3DаОЦЌетвЛаТаЭИХФюЃЌБШШчДЫЧАВЛОУЕФ3DДІРэЦїаОЦЌЁЃ 
аОЦЌ“ФІЬьДѓТЅ”
ЁЁЁЁ2011Фъ10дТжабЎЃЌЯрЙиУНЬхБЈЕМЃЌIBMгы3MЙЋЫОЭЦГіФІЬьДѓТЅЕФДІРэЦїаОЦЌЃЌЭЈЙ§вЛжжЬиЪтЕФЙшНКеГКЯМСНЋаОЦЌзщКЯдквЛЦ№ЃЌГЩЮЊаОЦЌ“ФІЬьДѓТЅ”ЁЃ>> ЁЁЁЁIBMКЭ3MаћГЦЃЌетжжФІЬьДѓТЅЕФЮЂДІРэЦїФмБШЦеЭЈЕФДІРэЦїадФмЬсЩ§1000БЖЁЃ 
3DаОЦЌ“ЫЎРф”ЩшМЦ
ЁЁЁЁОЭЯёФІЬьДѓТЅВЛШчЦНЗПЭСТЅФЧбљЖЌХЏЯФСЙвЛбљЃЌ3DаОЦЌЕФЩЂШШЮЪЬтвЛжБЪЧЗДЖдепЫљжЪвЩЕФЕиЗНЁЃЯыЯыФПЧАДІРэЦїЩЂШШЖМЪЧЭјгбдкЙКТђБЪМЧБОЪБПМТЧЕФвЛИіживЊЯюФПЃЌ3DаОЦЌЕФЩЂШШЮЪЬтПЩЯыЖјжЊЁЃдк2008ФъЃЌIBMЛЙЩшМЦгУЫЎРДИј3DаОЦЌНЕЮТЁЃ 
аОЦЌ“ФІЬьДѓТЅ”ЩЂШШ
ЁЁЁЁЖјдкIBMгы3MЙЋЫОКЯзїЕФ“ФІЬьДѓТЅ”ДІРэЦїаОЦЌжаЃЌЩЂШШЕФЮЪЬтгЩ3MЙЋЫОЩшМЦЩњВњЕФЬиЪтЙшНКНтОіЁЃ 
3DаОЦЌвКРф
ЁЁЁЁ2011ФъIBM 3DаОЦЌДѓЛсЩЯЃЌIBMБэЪОЮДРДЕФСЂЬхаОЦЌМмЙЙжаНЋЛсЪЕЯжвКРфММЪѕЁЃ 
ФІЖћЖЈТЩ
ЁЁЁЁШЋЮФзмНсЃКНќФъРДЫцзХаОЦЌЙЄвеЕФВЛЖЯЗЂеЙЃЌОЇЬхЙмЕФГпДчвВдНРДдННгНќЮяРэМЋЯоЃЌеќОШФІЖћЖЈТЩвВЫцжЎЬсГіЃЌаТВФСЯвдМА3DНсЙЙНЋЪЧживЊЕФСНИізХЪжЕуЃЌФІЖћЛЙЫЕЙ§ЃЌФІЖћЖЈТЩВЛЪЧЖЈТЩЃЌЫћЪЧвЛИіЛњгіЃЌеќОШФІЖћЖЈТЩвВашвЊВЛЖЯЭЦГТГіаТЕФММЪѕЃЌЖјдкетвЛЙ§ГЬжаЃЌЫФмеМЕУЯШЛњЃЌЬсЩ§МЏГЩЕчТЗЕФОЇЬхЙмУмЖШЃЌЬсИпаОЦЌадФмЃЌЫОЭНЋдкЮДРДЕФаОЦЌНчеОЮШНХИњЁЃ[ЗЕЛиЦЕЕРЪзвГ]
|