|
ЁЁЁЁIBMЕФЮФМўЯдЪОЃЌЦф3DДІРэЦїМмЙЙЙВгаСНВуаОЦЌЃЌЦфжаЕзВуЕФДІРэЦїОЙ§ЬиЪтДІРэЯрБШРДЫЕЛсБЁвЛЕуЃЌСНВуаОЦЌжЎМфЭЈЙ§Pb-Free C4ЯрСЌНгЁЃ
ЁЁЁЁIBMЖд3DаОЦЌЕФбаОПгЩРДвбОУЃЌЦфКЭУРЙтЙЋЫОЃЈMicronЃЉМЦЛЎЭЦГіЕФ3DФкДцаОЦЌHMCЃЌДцШЁЪ§ОнФмДя128GbpsЃЌЪЧФПЧАФкДцЕФ10БЖЁЃЫцзХаОЦЌжЦГЬЙЄвеДг65nmЃЌ45nmдйЕН22nmЃЌЕчТЗЕФУмМЏЖШдНРДдНИпЃЌЪЦБиЛсДяЕНвЛИіММЪѕЩЯЕФЦПОБЃЌдкЕчТЗУмМЏЖШЩЯДяЕНвЛИіМЋЯоЃЌЖј3DаОЦЌЕФЩшМЦИХФюЕФГіЯжЃЌИјЬсИпаОЦЌадФмПЊЭиСЫСэЭтвЛИіЭООЖЁЃ
ЁЁЁЁHybrid Memory CubeЃЈHMCЃЉЃЌЛьКЯСЂЗНФкДцаОЦЌЃЌгЩУРЙтЙЋЫОЬсГіЃЌетжжЛьКЯСЂЬхФкДцгыCPUЕФЪ§ОнДЋЪфЫйЖШНЋЪЧЯжНзЖЮФкДцММЪѕЕФ15БЖЃЌвдБуЪЪгІИпЫйЗЂеЙЕФДІРэЦїКЭПэДјЭјТчЁЃ ЁЁЁЁГ§СЫ3DаОЦЌФкДцЃЌРЖЩЋОоШЫIBMЛЙЛ§МЋгыИїГЇЩЬКЯзїЭЦНј3DаОЦЌетвЛаТаЭИХФюЃЌБШШчДЫЧАВЛОУЕФ3DДІРэЦїаОЦЌЁЃ
ЁЁЁЁ2011Фъ10дТжабЎЃЌЯрЙиУНЬхБЈЕМЃЌIBMгы3MЙЋЫОЭЦГіФІЬьДѓТЅЕФДІРэЦїаОЦЌЃЌЭЈЙ§вЛжжЬиЪтЕФЙшНКеГКЯМСНЋаОЦЌзщКЯдквЛЦ№ЃЌГЩЮЊаОЦЌ“ФІЬьДѓТЅ”ЁЃ>>
|
е§дкдФЖСЃК45nm 3DаОЦЌ IBMНЋЙЋВМСЂЬхаОЦЌММЪѕЯИНк45nm 3DаОЦЌ IBMНЋЙЋВМСЂЬхаОЦЌММЪѕЯИНк
2012-12-15 00:15
ГіДІЃКPConlineдДД
д№ШЮБрМЃКxiongxuehui
МќХЬвВФмЗвГЃЌЪдЪдЁАЁћ ЁњЁБМќ
| БОЮФЕМКН | ||
|
ЗўЮёЦїВњЦЗБЈМл
ЗўЮёЦїХХааАё зюаТБЈМл
ШШДЪЃК
ЫўЪНЗўЮёЦї
ЛњМмЪНЗўЮёЦї
ЕЖЦЌЪНЗўЮёЦї
ITШШДЪ
ШШУХХХаа
ITАйПЦ
ШШУХзЈЬт
ЗўЮёЦїТлЬГЬћзгХХаа
зюИпЕуЛї
зюИпЛиИД
зюаТ
ЦћГЕзЪбЖ
зюаТзЪбЖРыЯпЫцЪБПД
СФЬьЭТВлгЎНБЦЗ
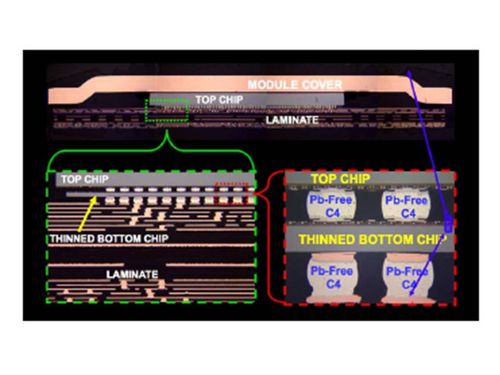
 ЁЁ
ЁЁ
